IC 封装教材.docx
《IC 封装教材.docx》由会员分享,可在线阅读,更多相关《IC 封装教材.docx(14页珍藏版)》请在冰豆网上搜索。
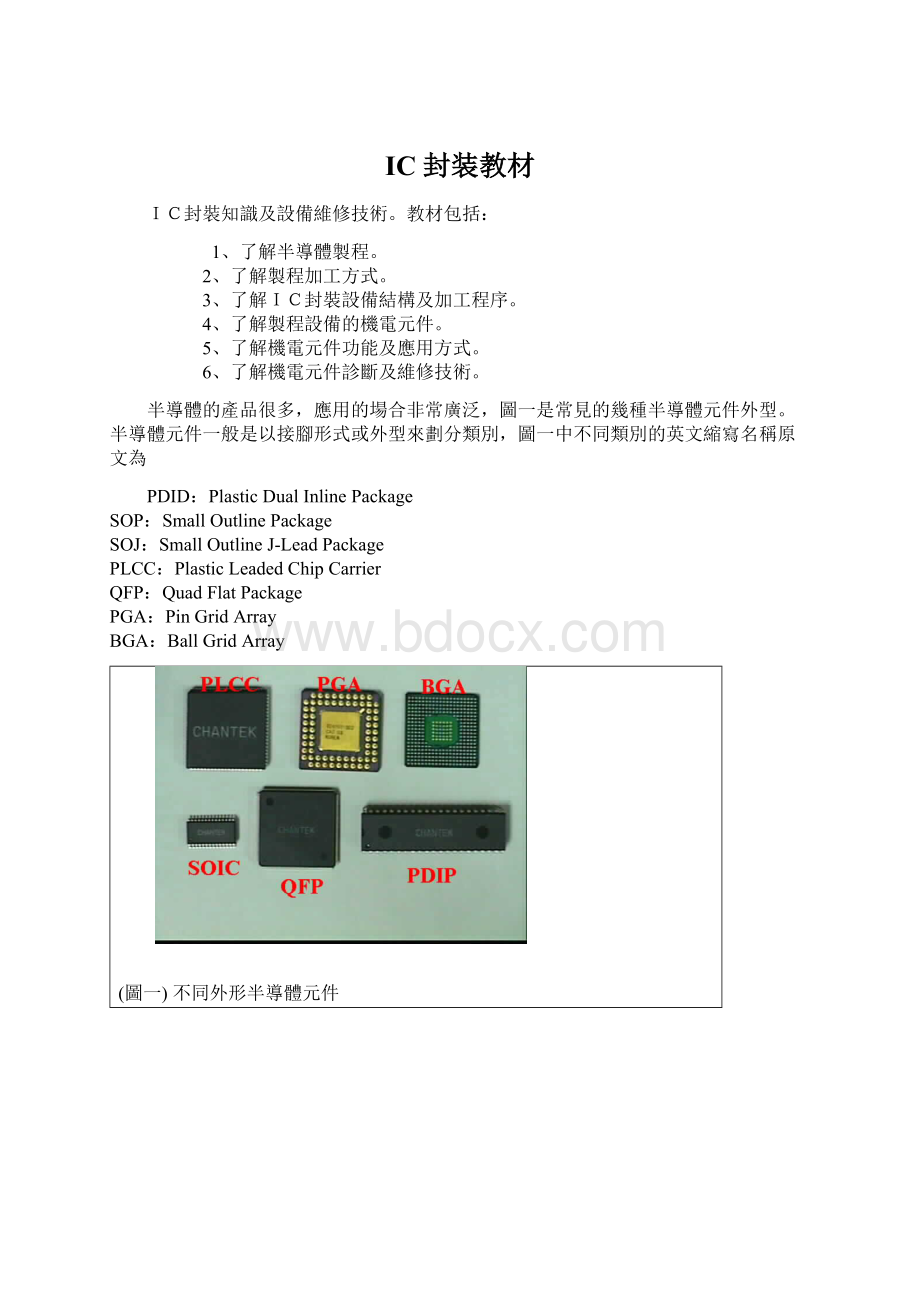
IC封装教材
IC封裝知識及設備維修技術。
教材包括:
1、了解半導體製程。
2、了解製程加工方式。
3、了解IC封裝設備結構及加工程序。
4、了解製程設備的機電元件。
5、了解機電元件功能及應用方式。
6、了解機電元件診斷及維修技術。
半導體的產品很多,應用的場合非常廣泛,圖一是常見的幾種半導體元件外型。
半導體元件一般是以接腳形式或外型來劃分類別,圖一中不同類別的英文縮寫名稱原文為
PDID:
PlasticDualInlinePackage
SOP:
SmallOutlinePackage
SOJ:
SmallOutlineJ-LeadPackage
PLCC:
PlasticLeadedChipCarrier
QFP:
QuadFlatPackage
PGA:
PinGridArray
BGA:
BallGridArray
(圖一)不同外形半導體元件
(圖二)EPROM內部晶片
(圖三)EPROM晶片接腳放大圖
(圖四)LED燈
(圖五)LED內部晶片放大圖
(圖六)LED通電時因晶片發亮而發光
雖然半導體元件的外型種類很多,在電路板上常用的組裝方式有二種,一種是插入電路板的銲孔或腳座,如PDIP、PGA,另一種是貼附在電路板表面的銲墊上,如SOP、SOJ、PLCC、QFP、BGA。
從半導體元件的外觀,只看到從包覆的膠體或陶瓷中伸出的接腳,而半導體元件真正的的核心,是包覆在膠體或陶瓷內一片非常小的晶片,透過伸出的接腳與外部做資訊傳輸。
圖二是一片EPROM元件,從上方的玻璃窗可看到內部的晶片,圖三是以顯微鏡將內部的晶片放大,可以看到晶片以多條銲線連接四周的接腳,這些接腳向外延伸並穿出膠體,成為晶片與外界通訊的道路。
請注意圖三中有一條銲線從中斷裂,那是使用不當引發過電流而燒毀,致使晶片失去功能,這也是一般晶片遭到損毀而失效的原因之一。
圖四是常見的LED,也就是發光二極體,其內部也是一顆晶片,圖五是以顯微鏡正視LED的頂端,可從透明的膠體中隱約的看到一片方型的晶片及一條金色的銲線,若以LED二支接腳的極性來做分別,晶片是貼附在負極的腳上,經由銲線連接正極的腳。
當LED通過正向電流時,晶片會發光而使LED發亮,如圖六所示。
半導體元件的製作分成兩段的製造程序,前一段是先製造元件的核心─晶片,稱為晶圓製造;後一段是將晶中片加以封裝成最後產品,稱為IC封裝製程,又可細分成晶圓切割、黏晶、銲線、封膠、印字、剪切成型等加工步驟,在本章節中將簡介這兩段的製造程序。
須經過下列主要製程才能製造出一片可用的晶片,以下
是各製程的介紹:
(1)長晶(CRYSTAL GROWTH):
長晶是從矽沙中(二氧化矽)提鍊成單晶矽,製造過程是將矽石(Silica)或矽酸鹽 (Silicate) 如同冶金一樣,放入爐中熔解提鍊,形成冶金級矽。
冶金級矽中尚含有雜質,接下來用分餾及還原的方法將其純化,形成電子級矽。
雖然電子級矽所含的矽的純度很高,可達99.999999999%,但是結晶方式雜亂,又稱為多晶矽,必需重排成單晶結構,因此將電子級矽置入坩堝內加溫融化,先將溫度降低至一設定點,再以一塊單晶矽為晶種,置入坩堝內,讓融化的矽沾附在晶種上,再將晶種以邊拉邊旋轉方式抽離坩堝,而沾附在晶種上的矽亦隨之冷凝,形成與晶種相同排列的結晶。
隨著晶種的旋轉上升,沾附的矽愈多,並且被拉引成表面粗糙的圓柱狀結晶棒。
拉引及旋轉的速度愈慢則沾附的矽結晶時間愈久,結晶棒的直徑愈大,反之則愈小。
觀賞長晶動畫模擬 (請調整wav音量)
長晶可拉出不同外徑大小的晶棒,經以下加工可製成不同外徑之晶圓(Wafer),圖一中三片晶圓直徑分別為125mm、150mm及200mm。
台灣製造晶圓有中德電子材料等公司,在中德公司網站上有更詳細相關資料。
圖一 圖二
(2)切片(SLICING):
從坩堝中拉出的晶柱,表面並不平整,經過工業級鑽石磨具的加工,磨成平滑的圓柱,並切除頭尾兩端錐狀段,形成標準的圓柱,被切除或磨削的部份則回收重新冶煉。
接著以以高硬度鋸片或線鋸將圓柱切成片狀的晶圓(Wafer)。
(3)邊緣研磨(EDGE-GRINDING):
將片狀晶圓的圓周邊緣以磨具研磨成光滑的圓弧形,如此可
(1)防止邊緣崩裂,
(2)防止在後續的製程中產生熱應力集中,(3)增加未來製程中鋪設光阻層或磊晶層的平坦度。
(4)研磨(LAPPING)與蝕刻(ETCHING):
由於受過機械的切削,晶圚表面粗糙,凹凸不平,及沾附切屑或污漬,因此先以化學溶液(HF/HNO3)蝕刻(Etching),去除部份切削痕跡,再經去離子純水沖洗吹乾後,進行表面研磨拋光,使晶圓像鏡面樣平滑(如上圖二可反射景物),以利後續製程。
研磨拋光是機械與化學加工同時進行,機械加工是將晶圓放置在研磨機內,將加工面壓貼在研磨墊(PolishingPad)磨擦,並同時滴入具腐蝕性的化學溶劑當研磨液,讓磨削與腐蝕同時產生。
研磨後的晶圓需用化學溶劑清除表面殘留的金屬碎屑或有機雜質,再以去離子純水沖洗吹乾,準備進入植入電路製程。
(5)退火(ANNEALING):
將晶片在嚴格控制的條件下退火,以使晶片的阻質穩定。
(6)拋光(POLISHING):
晶片小心翼翼地拋光,使晶片表面光滑與平坦,以利將來再加工。
(7)洗淨(CLEANING):
以多步驟的高度無污染洗淨程序-包含各種高度潔淨的清洗液與超音動處理-除去晶片表面的所有污染物質,使晶片達到可進行晶片加工的狀態。
(8)檢驗(INSPECTION):
晶片在無塵環境中進行嚴格的檢查,包含表面的潔淨度、平坦度以及各項規格以確保品質符合顧客的要求。
(9)包裝(PACKING):
通過檢驗的晶片以特殊設計的容器包裝,使晶片維持無塵及潔淨的狀態,該容器並確保晶片固定於其中,以預防搬運過程中發生的振動使晶片受損。
製程
經過晶圓製造的步驟後,此時晶圓還沒任何的功能,所以必須經過
積體電路製程,才可算是一片可用的晶圓。
附圖一是完成積體電路製
程的晶圓(此晶圓係瑕疵品,晶圓上的紅色線框,是人工加上的標記。
)
圖一
以下是積體電路製程的流程圖:
磊晶
微影
氧化
擴散
蝕刻
金屬連線
磊晶(Epitoxy)
磊晶一詞源自於希臘文的epi(在上)和 taxis(有秩序的排列),其意乃有秩序的排列
在其上。
磊晶是單晶基板上成長薄膜的延伸,經由在單晶基板上增添的原子而形
成的一個單晶結構的連續體。
其原理可分為:
(1)液相磊晶(LiquidPhaseEpitoxy,LPE)
液相磊晶成長是從液相中直接利用沉積法,在晶質基板上成長磊晶層,這種
方法對於砷化鎵(GaAs)的成長和其相關的III-V族化合物特別有用。
液相磊晶成長
適合成長薄的磊晶層(≧0.2μm),因為它具有低的成長速率,所以較其他方法有
用。
(2)氣相磊晶(VaporPhaseEpitoxy,VPE)
氣相晶矽層的成長稱為氣相磊晶。
在其過程中,是用基板晶圓(Substratewafer)
當作一晶種。
在各種磊晶成長方法中,氣相磊晶成長是目前成長矽元件最主要的
方法。
而在氣相磊晶中又可分成物理氣相沉積(PhysicalVaporDeposition,PVD)
和化學氣相沉積(ChemicalVaporDeposition,CVD)兩種技術。
前者主要是藉物理
現象而後者則主要是以化學反應的方式,來進行薄膜的沉積。
而PVD的應用大
都侷限在金屬薄膜的沉積上,相反的,凡是所有半導體元件所需要的薄膜,不
論半導體、導體或介電材料(Dielectrics),都可藉由CVD法來進行配製。
因為CVD
是藉反應氣體間的化學反應來產生所需要的薄膜,因此CVD法所製作的薄膜材料
,其結晶性(Crystallinity)和理想配比(Stoichiometry)等與材質相關的一些性質,都
比PVD法好很多。
(3)分子束磊晶(MolecularBeamEpitoxy,MBE)
分子束磊晶成長是在超高真空的情形下,一個或多個熱原子或熱分子束在一
結晶表面所產生的效果。
MBE法能夠精確的控制化學組成和摻雜剖面,所以是近
年來最熱門的磊晶技術。
微影(Lithography)
微影(Lithography)製程的技術,是在晶片的表面上覆上一層感光材料光阻,
利用光源的平行光,透過光罩打在這層感光材料上。
因為光罩上有IC佈線的圖案
,因此透過光罩的光會在感光材料上,顯出IC佈線的影像,這個步驟稱為曝光
(Exposure)。
此時有兩種做法,每一種做法需使用不同特性的感光材料,第一種
做法是圖案上透光的部份是佈線圖形,而另一種做法是圖案上不透光的部份才是
佈線圖形。
由微影製程所形成的光阻圖案,並不是元件的最終圖形,僅是電路圖
形的複製而已。
為了加強光阻覆蓋的特性,使得圖案的轉移有更好的精確度,整個微影製
程包含了七個細部動作。
(1)表面清洗;(2)塗底(Priming);(3)光阻覆蓋;(4)軟烤(SoftBake);(5)曝
光;(6)顯影;(7)硬烤。
氧化(Oxidation)
積體電路製程技術中,在半導體晶片的表面上形成一層穩定的氧化層是一項
非常重要的關鍵步驟。
此氧化層主要目的是保護P-N接面不受外界環境的污染,
亦可當作電性絕緣之用。
此氧化保護層是將矽晶片置於高溫的氧化環境中加熱而
成。
擴散(Diffusion)
在半導體工業上主要是藉由高溫將摻質(doping)原子滲入半導體晶片中。
擴
散的方式可以藉由單一的操作程序並且可同時處理大約200至250個晶片,它的優
點是可產生較小的逆向漏電流、高品質的p-n接面、以及較小的晶格破壞,
所以被廣泛地使用。
蝕刻(Etching)
所謂蝕刻即指經由乾、濕的物理作用或化學反應之過程去除工件上某特定區
域上之薄膜。
在微影術步驟完成之後,光罩的圖案被複製在光阻層上,再應用蝕
刻去除光阻層上不要的部份,以便進行下一步加工。
目前在半導體製程上有二種
蝕刻的方法,而兩者的差別取決於蝕刻劑為液態溶液或氣體。
金屬連線(Metallization)
金屬連接是在各微小元件之間建立彼此連接的線路。
在高度真空下,將鋁加
熱並蒸發為氣態,如此氣態鋁便可均勻地蒸鍍於晶圓上。
在此製程裡所選用的金
屬必須要有低電阻質,容易加工處理,我們一般所使用的是鋁、銅、鎢這類的金
屬材料,而金屬連線間的絕緣層則多半是使用二氧化矽。
由於線寬技術的縮小化
,以及各種新材料的引進所增加的複雜性,使得我們在金屬連線製程上必須引進
一些材料,來讓可靠度提高,例如鈦化鎢、氮化鈦、鈦等多種金屬化合物。
(DieSaw)
晶片切割之目的乃是要將前製程加工完成的晶圓上一顆顆之晶粒
(Die)切割分離。
首先要在晶圓背面貼上膠帶(bluetape)並置於鋼
製之框架上,此一動作叫晶圓黏片(wafermount),如圖一,而後再
送至晶片切割機上進行切割。
切割完後,一顆顆之晶粒井然有序的排
列在膠帶上,如圖二、三,同時由於框架之支撐可避免膠帶皺摺而使
晶粒互相碰撞,而框架撐住膠帶以便於搬運。
觀賞晶片切割動畫模擬(請調整wav音量)
圖一
圖二
圖三
(DieBond)
黏晶的目的乃是將一顆顆分離的晶粒放置在導線架(leadframe)
上並用銀膠(epoxy)黏著固定。
導線架是提供晶粒一個黏著的位置
(晶粒座diepad),並預設有可延伸IC晶粒電路的延伸腳(分為內
引腳及外引腳innerlead/outerlead)一個導線架上依不同的設計可以有
數個晶粒座,這數個晶粒座通常排成一列,亦有成矩陣式的多列排法
。
導線架經傳輸至定位後,首先要在晶粒座預定黏著晶粒的位置上點
上銀膠(此一動作稱為點膠),然後移至下一位置將晶粒置放其上。
而經過切割之晶圓上之晶粒則由取放臂一顆一顆地置放在已點膠之晶
粒座上。
黏晶完後之導線架則經由傳輸設備送至彈匣(magazine)內
。
黏晶後之成品如圖所示。
導線架
成品
(WireBond)
銲線的目的是將晶粒上的接點以極細的金線(18~50um)連接
到導線架上之內引腳,藉而將IC晶粒之電路訊號傳輸到外界。
當
導線架從彈匣內傳送至定位後,應用電子影像處理技術來確定晶粒
上各個接點以及每一接點所相對應之內引腳上之接點的位置,然後
做銲線之動作。
銲線時,以晶粒上之接點為第一銲點,內接腳上之
接點為第二銲點。
首先將金線之端點燒結成小球,而後將小球壓銲
在第一銲點上(此稱為第一銲,firstbond)。
接著依設計好之路徑
拉金線,最後將金線壓銲在第二銲點上(此稱為第二銲,second
bond),同時並拉斷第二銲點與鋼嘴間之金線,而完成一條金線之
銲線動作。
接著便又結成小球開始下一條金線之銲線動作。
銲線完
成後之晶粒與導線架則如圖一所示。
圖二為30µØ之金線與頭髮的比
較。
圖一 成品 第一銲點
圖二 第二銲點
金線銲接 金線結球 銲線機流程動畫
(Mold)
封膠之目的有以下數點:
1、防止濕氣等由外部侵入。
2、以機械方式支持導線。
3、有效地將內部產生之熱排出於外部。
4、提供能夠手持之形體。
封膠之過程比較單純,首先將銲線完成之導線架置放於
框架上並先行預熱,再將框架置於壓模機(moldpress)上的
封裝模上,此時預熱好的樹脂亦準備好投入封裝模上之樹脂
進料口。
啟動機器後,壓模機壓下,封閉上下模再將半溶化
後之樹脂擠入模中,待樹脂充填硬化後,開模取出成品。
封
膠完成後的成品,可以看到在每一條導線架上之每一顆晶粒
包覆著堅固之外殼,並伸出外引腳互相串聯在一起(如圖所
示)。
成品
(Mark)
印字的目的,在註明商品之規格及製造者。
良好的印字令人有
高尚產品之感覺。
因此在IC封裝過程中亦是相當重要的,往往會
有因為印字不清晰或字跡斷裂而遭致退貨重新印字的情形。
印字的方式有下列幾種:
1、印式:
直接像印章一樣印字在膠體上。
2、轉印式(padprint):
使用轉印頭,從字模上沾印再印字在膠體上。
3、雷射刻印方式(lasermark):
使用雷射直接在膠體上刻印。
為了要使印字清晰且不易脫落,IC膠體的清潔、印料的選
用及印字的方式,就相當的重要。
而在印字的過程中,自動化的
印字機有一定的程序來完成每項工作以確保印字的牢靠。
印字後
之成品如圖所示。
成品
(Trim/Form)
封膠完後之導線架需先將導線架上多餘之殘膠去除
(deflash),並且經過電鍍(plating)以增加外引腳之導電性
及抗氧化性,而後再進行剪切成型。
剪切之目的,乃是要將
整條導線架上已封裝好之晶粒,每個獨立分開。
同時,亦要
把不需要的連接用材料及部份凸出之樹脂切除(dejunk)。
剪切完成時之每個獨立封膠晶粒之模樣,是一塊堅固的樹脂
硬殼並由側面伸出許多支外引腳。
而成型的目的,則是將這
些外引腳壓成各種預先設計好之形狀,以便於爾後裝置在電
路板上使用,由於定位及動作的連續性,剪切及成型通常在
一部機器上,或分成兩部機(trim/dejunk,form/singular)上
連續完成。
成型後的每一顆IC便送入塑膠管(tube)或承載
盤(tray)以方便輸送。
照片所示乃剪切成型後之成品。
成品